液晶や半導体デバイスプロセスに用いられている高分子膜は、ポリマーの特性を生かした特殊な実用例であると言える。高品質でかつ無欠陥の高分子パターンを得る事は、製造においても重要な課題である。1983年にLongがポジ型高分子膜(フォトレジスト)にLSIパターンを紫外線で焼き付ける際にボイドが生じる事を初めて報告した。この現象は、最近の高解像高分子において顕著に見られている。しかし、このボイドの発生機構は、まだ十分に解析されていない。ここでは、ボイド形成ファクターとして、高分子膜中の感光剤濃度、及び付着エネルギーの2つに注目し、そのメカニズムを考察する。これらのファクター依存性を調べるため、感光剤濃度を変えた種々の高分子、及び表面エネルギーの異なる無機基板を用いてボイド発生実験を行った。高分子中の感光剤が光分解する際に生じるN2ガスによって、局所的に高分子膜が基板との付着力以上に押し上げられた時にボイドが発生すると考えられる。
感光剤濃度の異なる3種類の試作ポジ型高分子膜と市販のポジ型高分子膜の4タイプを実験に用いた。無機膜として、WSi2,SiO2,SiN膜をSi(100)6インチウェハにスパッタリング法,熱酸化法,CVD法によって各々形成した。また、Wsi2上にシランカップリング剤としてHMDS(ヘキサメチルジシラザン)のプライマー処理を行ったものも用いた。高分子膜は1μmの膜厚となるように、スピンコート法で形成した。ウェハ上の高分子膜の全領域に、ブランクマスクを用いてg-線用縮小投影露光機で紫外光を照射した。分解率は透過率計による紫外光吸収法によって同定した。高分子/基板界面に発生したボイドはパーテイクルカウンターを用いて計測した。
表面エネルギー理論を用いて、高分子膜/基板間の付着エネルギーを求める。下式より付着エネルギーは次のように表される。
EA = 2 ( αr αs + βr βs )
ここで高分子膜1とSi基板との場合、上式より付着エネルギーを次のように求める事ができる。
EA = 2 ×(5.64×5.20+3.11×4.13) = 84.4 erg/cm2
発生したN2ガスによって高分子膜が受ける歪エネルギーを以下の手法で求めた。歪エネルギーを求める際に、次の2つの仮定を行った。
1)高分子膜内に発生したNガスの全てが、高分子膜/基板界面に集中する。すなわち、高分子膜表面からの放出は考慮しない。
2)ボイドが発生したエリア(円形)の高分子膜に発生するN2ガスのみを考える。すなわち、発生したN2ガスの横方向の拡散はないものとする。

この計算に用いた各物理定数を上表にまとめた。一例として、高分子膜の感光剤が50%分解された場合を考察する。1μm膜厚で1cm2領域に発生したN2ガス体積Voは、
VO = GO / DO = 7.29 × 10-4cm-3
となる。この値は、この領域の高分子膜の体積の約7倍にあたる。この体積のN2ガスが瞬時に発生するため、高分子膜はかなりの圧縮応力を受けるものと考えられる。よって、凝集力が弱い基板との界面に発生したN2ガスが集中する。そして、高分子膜を押し上げ、ボイドを形成する。ボイド発生を引き起こすN2ガスの体積VBは
VB = VO× SB = 3.3×10-7cm-3 (1)
となる。発生したボイドの内圧PB(応力σB)は以下のようになる。
PB(σB) = (VB/ V1) × 1atom = 7×10-7 erg/cm3 (2)
この内圧(応力)より高分子膜が受ける歪エネルギーeBは、
eB = σB2×2E = 82.8×104 erg/cm3 (3)
となる。1μm膜厚の高分子膜の場合、歪エネルギーESは
ES = eB×tr = 8.38 erg/cm2 (4)
となる。
下の左図(a),(b)には紫外光照射後に高分子膜/基板界面に発生したボイド写真を示している。ボイド形状は直径100から300μmのほぼ円形である。(a)のように高分子膜の浮き上がりによる干渉渦だけでなく、(b)の様な完全に高分子膜片が飛び散っているものも見られている。また、ウェハの中心部より外周部の方が、多くのボイド発生が見られる。ボイドは紫外光照射した領域のみに発生し、未照射部には発生は見られない。よって、高分子膜内に発生したN2の放出過程がボイドの発生に密接に関係していると推定できる。下の右図には、ボイド発生メカニズムをフローチャートで示している。(a)高分子膜が基板上に均一に塗布・形成されている。(b)膜全面に紫外光を照射する。(c)発生したN2ガスは拡散し始める。その放出速度は感光剤濃度に比例する。(d)発生したN2ガスは高分子膜表面から放出されていく。ここでN2ガスの発生レートが放出速度よりもかなり大きい場合、N2ガスは高分子膜/基板界面のような結合力の小さい領域へ集中する。このN2ガスの発生によって、高分子膜は過剰な圧縮応力を受ける事となる。結果として、このN2ガスによって、高分子膜は基板から引き離される方向に応力を受ける事となる。よって、(e)高分子膜の凝集破壊が生じ周囲へ飛散する結果となる。もし、高分子膜と基板の付着力が高ければボイドの発生は見られず、N2ガスは横方向へ拡散していくと考えられる。ボイド形成に関与するファクターとして、以下の3つが考えられる。それは、(i)N2ガス発生により生ずる高分子膜の歪エネルギー、(ii)高分子膜と基板との付着エネルギー、(iii)紫外光照射時の高分子膜中でのエネルギー効率である。ここで、ボイドは高分子膜の歪エネルギーEsが付着エネルギーEAを超えた時に発生すると仮定する。(i)に関する物理量として、(1)N2ガスの発生量(これは高分子膜内の感光剤濃度に対応する。)、(2)N2ガスの放出レート、(3)高分子膜の弾性定数が挙げられる。(ii)については、(1)表面自由エネルギー、(2)表面粗さ、(3)高分子膜と基板とのストレスマッチングなどがある。(iii)としては、(1)紫外線照射全エネルギー量、(2)照射面積、(3)照射エネルギー密度がある。ここでは、上記のファクターの中で(i)と(ii)の2つに注目した。
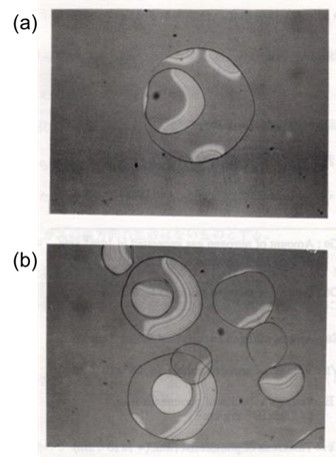
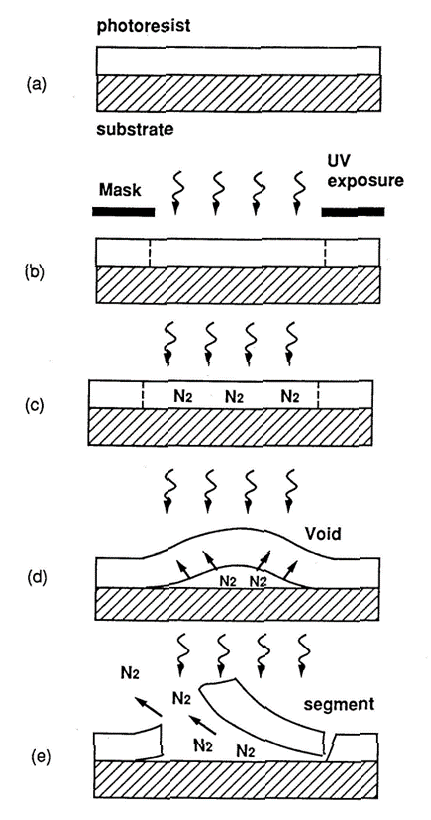
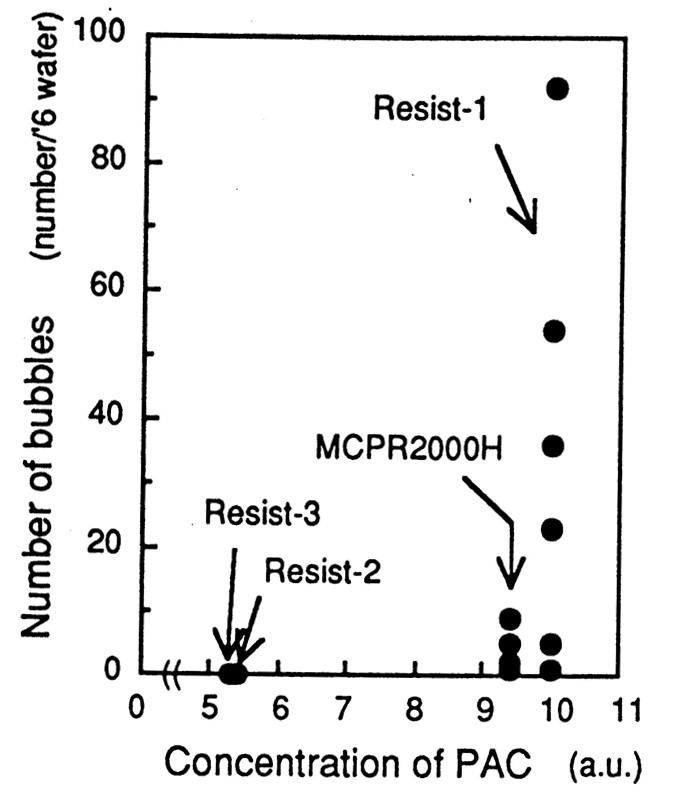
右図は、高分子膜内の感光剤濃度とボイド発生量との相関を示している。感光剤濃度はモル分率に対応した任意単位(a.u.)で表している。1種類の高分子膜に対して、6枚のウェハのデータ値を示している。黒丸1ヶはウェハ1枚のデータを表している。感光剤濃度が増加するにつれ、ボイド発生量も増加する。また、そのばらつきも増加している。これより、感光剤濃度は要因の1つとなりうる事がわかる。他の要因として、高分子膜と、無機基板との付着エネルギーEAを考察する。付着エネルギーを求めるために、各膜の表面エネルギー成分を求めた。下の左表、及び下の右図には各基板,高分子膜表面の分散α、極性βプロットを示している。空気の場合はα=β=0のポイントを意味する。高分子膜は全てα:5.63~6.02(dyn/cm)1/2の狭い範囲に集中している事がわかる。また、高分子膜は、無機基板と比べて低い極性値を示している。SiO2,WSi2,SiNの無機基板はSiよりも高い極性成分を示している。この極性成分は基板表面の-OH基等の極性基密度に対応していると考えられる。HMDSプライマー処理を行う事によって、極性成分がわずかに減少する事がわかる。たとえばWsi2の場合、6.12から5.11(dyn/cm)1/2へと減少する。全体的に各基板間の極性成分の差は、分散成分よりも明らかに広いことがわかる。よって、付着エネルギーに対し、極性成分は分散成分よりも強く影響する事が考えられる。

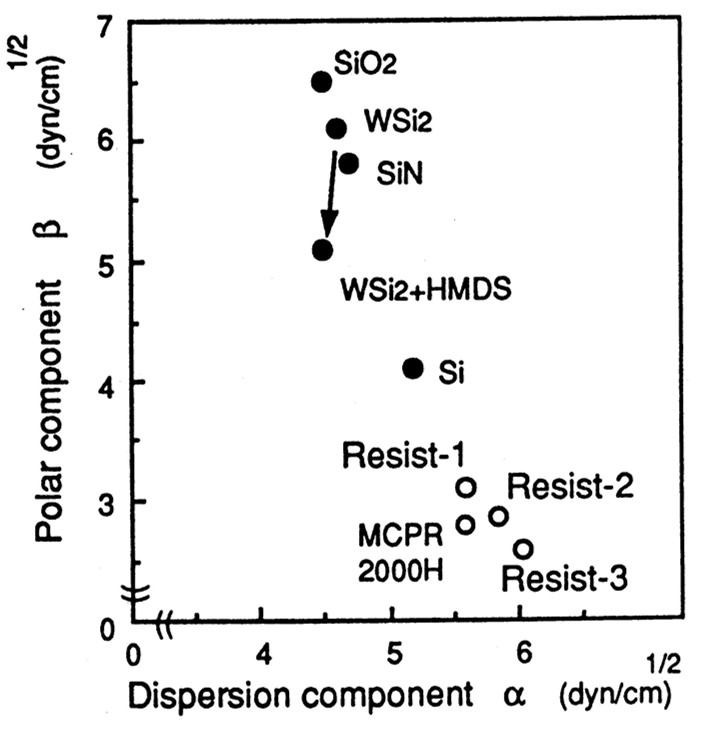
下の左図は、高分子膜1の場合の付着エネルギーとボイド数との相関を示している。各基板との付着エネルギーは80~95erg/cm2の範囲の大きさになる事がわかる。付着エネルギーの増加と共にボイド数は減少している。よって、基板の表面エネルギーは、ボイド発生に密接に影響している事がわかる。
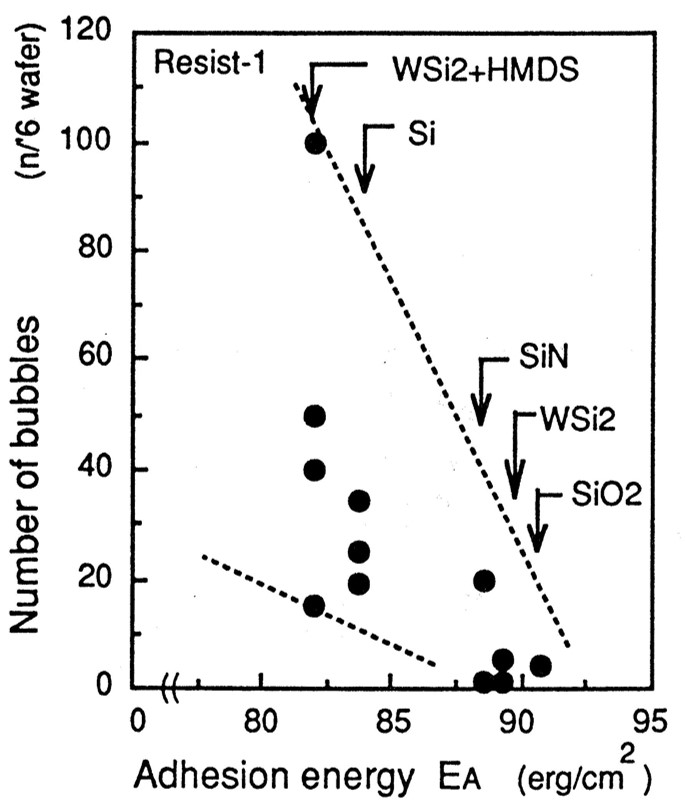
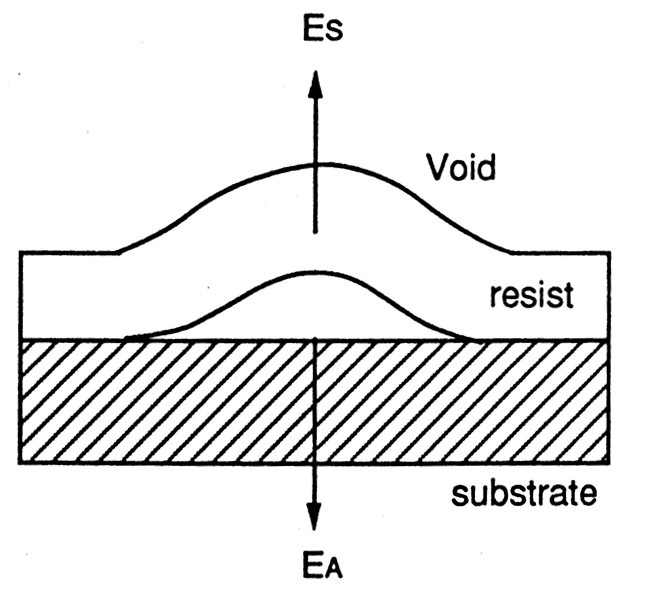
上の右図は、高分子膜/基板界面に生じる付着、歪の両エネルギーをベクトルで表したものである。ここで形成ファクターUとして、基板と高分子膜との付着エネルギーEAと歪エネルギーES(2つは互いに逆向きのベクトルを有する。)を用いて、次式のように定義する。
U = EA- ES
歪エネルギーESが付着エネルギーEAを超えた場合(すなわち、Uが0以下の場合)、高分子膜は基板より剥がされボイドが形成されると考えられる。逆にU値が0以上の場合には、ボイド形成は起こらないとする。そこで、2つのエネルギーEA, ESの各測定値から得られるU値を用いてボイド形成の推定を行う。下の左図は、種々の高分子膜と基板との組合せによる付着エネルギーEAを示している。高分子膜間には4erg/cm2の差が見られ、これは付着エネルギーの約5%に相当する。表面の極性が比較的高いSiO2基板の場合には、高分子膜と大きな付着エネルギーを示す。基板の極性成分に応じて付着エネルギーに変化する。次に、式(1)~(4)により求めた各高分子膜の受ける歪エネルギーを下の右図に示す。歪エネルギーは感光剤濃度の二乗に比例して増えていく。LSIの製造プロセスで用いられる50%の感光剤分解率では、高分子膜間の歪エネルギーEsの差は約30erg/cm2となる。これは高分子膜間の付着エネルギーの差4erg/cm2に比べてかなり大きい値となっている。よって、高分子膜間の歪エネルギーの差は、付着エネルギーに比べ形成ファクターUにより強く影響する事が考えられる。
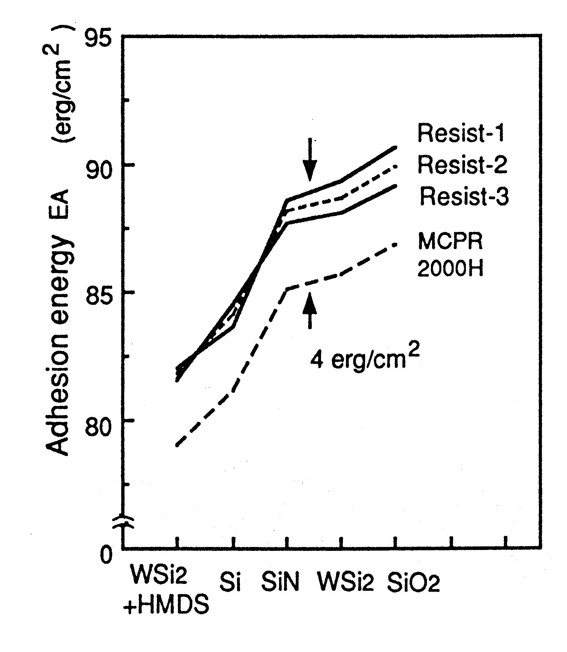
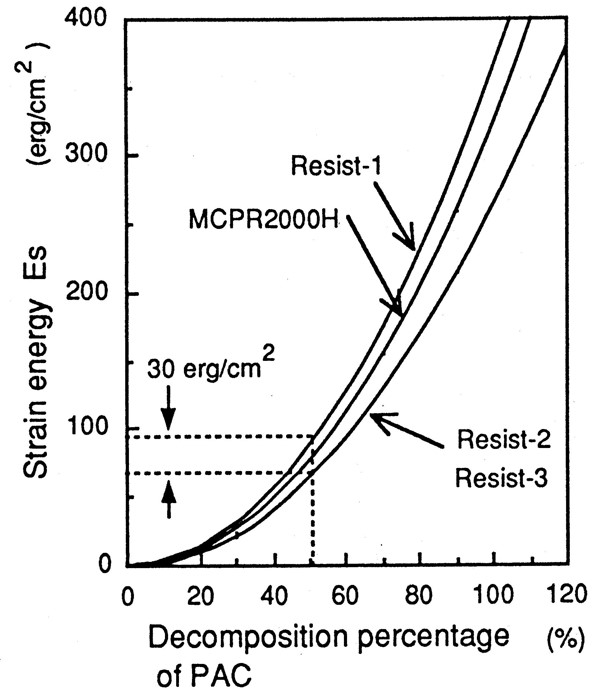
下の左図には、種々の高分子膜と基板との組合せにおける形成ファクターUとボイド発生数との相関を示している。形成ファクターUは感光剤濃度の増加と共に線形に減少する結果となっている。Si基板の場合、U値が0erg/cm2以上になる高分子膜(2, 3)についてボイドが発生すると予想される。一方、U値が0以下になるMCPR2000H, 高分子膜1の場合はボイドは形成されないと考えられる。下の右図は、Si基板上でのボイド発生数と形成ファクターUとの相関を示している。下の左図でのU値による推定どおりにボイドの発生が見られている。よって、この形成ファクターUを用いて種々の高分子と基板との組合せにおけるボイド形成を予想する事ができる。また、感光剤濃度及び表面エネルギーをコントロールする事により、このボイド発生を防止する事が可能になると結論できる。


高分子膜/基板界面に紫外線照射中に発生するボイド形成について考察を行った。
1)高分子膜に発生した歪エネルギーによって、基板と高分子膜の付着は破壊され高分子膜が局所的に浮き上がる事によりボイドは形成される。
2)感光剤濃度と表面エネルギーはボイド形成の主要因である。
3)基板/高分子膜間の付着エネルギーと高分子膜の歪エネルギーの差で表される形成ファクターUは種々の高分子膜/基板の組合せにおけるボイドの発生を予想するのに適している。
参考文献