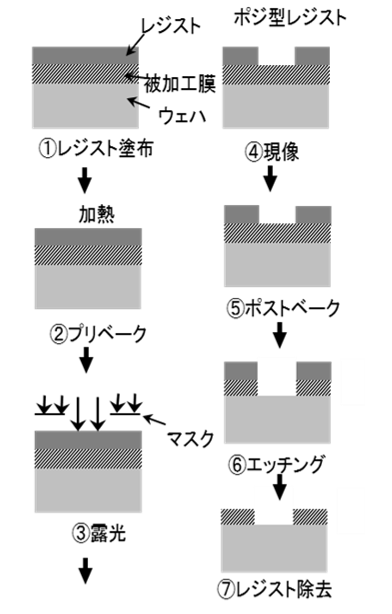
半導体集積回路(LSI)や液晶プラズマ表示機器に代表されるように、電子デバイス産業の発展の歴史は注目に値する。電子デバイスの作製には、多くのプロセス技術の集合と最適化が不可欠であるが、その中でも、デバイスの設計基準に直接関わる光リソグラフィ技術の発展は欠かせない。このプロセスは、右図のように、マスク作製、レジストコート、プリベーク、パターン露光焼付け、アルカリ現像、純水リンスから成り立っている。そして、現像されたレジストパターンを用いて、下地基板をエッチングして金属配線を形成する。その後、マスクとなったレジストパターンは除去される。ここで、エッチングには、ドライエッチングとウェットエッチングがある。また、めっきプロセスによって、レジストパターン間に金属配線を形成するリフトオフプロセスも実用化されている。以上のように、光リソグラフィには様々なウェットプロセスが関与するが、もし、レジストパターン間に気泡が付着した場合、現像不良やエッチング不良、および、めっき不良を引き起こす。下の左図はレジストパターン上への気泡付着の具体例を示しているが、気泡は安定してパターン上へ付着する。また、下の右図にあるように、気泡サイズが小さいほど、レジストへの付着率は増加する。ここでは、レジストパターン上の微小気泡の付着メカニズムと脱離特性について述べる。
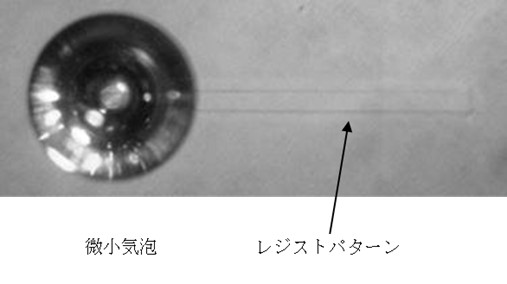

レジストパターンに捕獲された気泡の脱離特性を解析するには、まず、光リソグラフィによって微細な凹型の正方パターンを形成する。下の左図には、作製した正方パターンの構造と顕微鏡写真を示している。基板はCu膜であり、パターンはドライフィルムレジスト(DFR)で作製している。DFRは、メッキ工程で使用される代表的なレジスト材料である。マスク設計に基づいてパターン作製しているため、凹部の容積を正確に決定することができる。すなわち、この容積とほぼ同等の体積の気泡を形成できる。
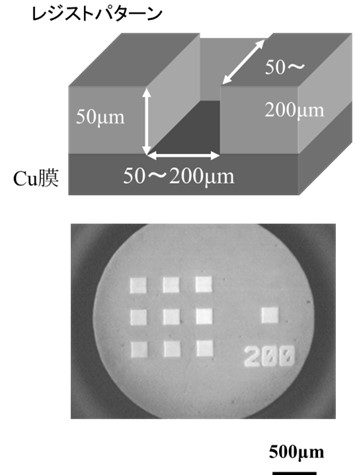
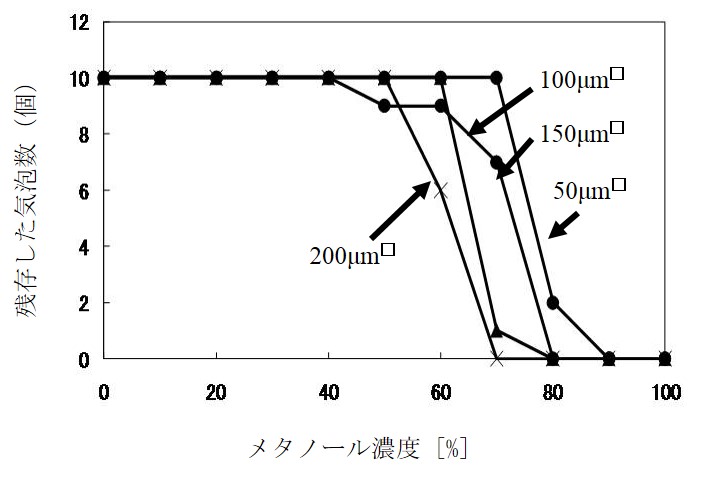
下図は、このパターンを純水中に浸漬させた場合の顕微鏡写真を示している。正方パターンの内部に気泡が捕獲されているのが確認できる。次に、この状態に、エタノールを徐々に添加して、気泡が脱離する様子を観察する。当初、気泡はパターン側壁に付着して歪んだ形状をしているが、40%のエタノール濃度になると、側壁への付着は減少し気泡は球形に近くなる。また、60%以上でパターンからの気泡の脱離が始まり、70%では、全ての気泡が脱離している。このように、徐々にエタノールを注入して、溶液の表面張力を減少させた場合、捕獲された気泡が浮遊していく様子が明確に分かる。この気泡の脱離現象を異なるパターン容積において測定した結果を、上の右図に示している。パターン容積が小さい場合ほど、気泡は脱離しにくくなる。これらの現象は、系の自由エネルギー変化に基づいて説明することができる。一般的に、系の自由エネルギーの低くなる方向へ現象は移行していく。この場合、レジストパターンから微小気泡が脱離することにより、系の自由エネルギーは減少していく。
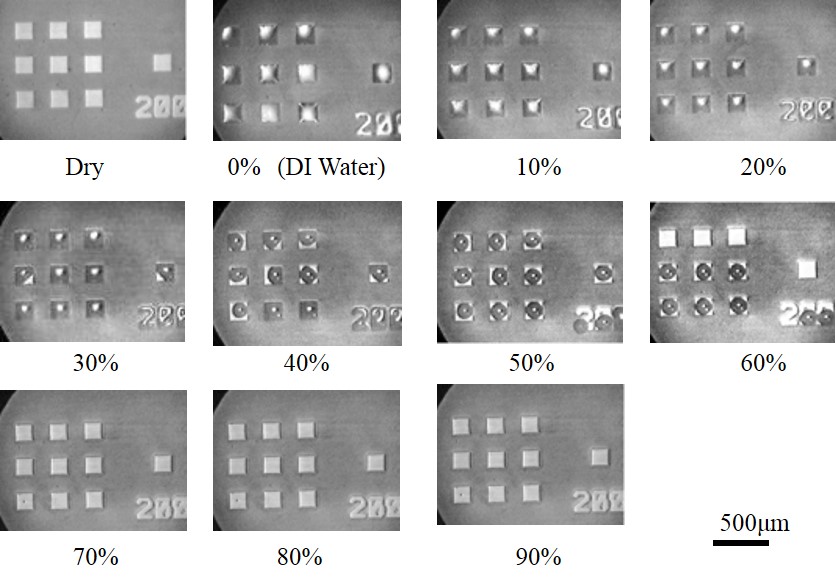
ライン状のレジストパターン内の凹部に捕獲された気泡は、パターン内を容易に移動する。下図のように、レジストパターンの凹部をライン状に形成した場合、気泡はライン内を移動し、パターンエッジ部で凝集する。ここで、パターン長さと幅は4mmと500μmであり、深さは50μmである。パターンの材質はDFRであり、基板はガラスである。一方、YとT形状パターンでは、中心角度が90度の場合に、気泡は中心に凝集するが、60度になるとパターンエッジ部に気泡は移動する。これは、中心部のパターン構造によって、自由エネルギーが変化し、気泡の安定性が変化していることを示している。このように、微細パターンにより微小気泡の付着脱離を定量的に解析できる。

参考文献