光リソグラフィ技術により作製されたレジストパターンの側面には、110~180nm程度の周期の波形模様が形成される。この波形模様は、パターン露光時の定在波効果に起因して形成される。原子間力顕微鏡(AFM)を用いて、直径0.61μm、高さ1.03μmの円筒形レジストパターンを基板上で剥離倒壊させて、パターン側面に形成された波形模様を観察した。波形模様の周期はパターン側面内で異なることより、レジストパターンの高さ方向の屈折率分布を求めた。その結果、屈折率は1.51~1.79の範囲で、パターン上部から底部へ向けて徐々に高くなっていることが分かった。これは、ホットプレートを用いた熱処理により、レジストパターン底部の凝集性が高くなったことを反映していると考えられる。この手法により、微小固体中の光学パラメータおよび凝集性を解析することが可能になる。
実験に用いたレジストの主成分は、m-クレゾール/p-クレゾール/キシレノール/ホルムアミドノボラック樹脂である。溶剤はECA(エチルセルソルブアセテート)である。レジストパターンの形成方法は以下の通りである。まず、スピンコート法により、レジスト膜をSi(100)単結晶基板上に形成した。スピンコートしたレジスト膜を乾燥させる目的で、ホットプレートを用いて100℃で1分間の熱処理を行った。その後、縮小投影露光装置(Nikon、NSR1505-G6E、g-line、NA=0.54)を用いて、300msecの露光時間で直径610nmのパターン形状の露光を行った。露光波長は365nm(i線)であった。パターン露光時には、定在波効果によって、レジスト膜の深さ方向に光学強度の周期的な濃淡が形成される。これは、後述のように、レジスト膜内で、入射光と基板からの反射光が干渉するために生じる。その後、レジストパターンをTMAH(テトラメチルアンモニウムハイドロオキサイド)2.38%水溶液中に漬けて、1分間の現像処理を行った。引き続き、純水中で1分間のリンス処理を行った。パターン現像とリンス処理時の環境温度は25℃であった。パターン側面に形成された波形模様は、AFM(SPA300、セイコー電子工業(株)製)、および走査型電子顕微鏡(SEM、JSM-35CFⅡ 日本電子(株)製)により観察した。AFMによる測定手法および条件は、以下の通りである。まず、本手法では、レジストパターンをDPAT法により剥離倒壊させて、パターン側面の波形模様を観察する。測定には、Si3N4製のカンチレバーを使用した。カンチレバーの先端には、AuコートしたSi3N4製の探針が取りつけられている。カンチレバーのバネ定数および探針先端の曲率半径は、それぞれ0.098N/mおよび20nmであった。探針からパターンへ加えた荷重は、カンチレバーの変位とバネ定数を掛けることで求まる。図1は、AFMによるパターン側面形状の解析方法を示している。まず、AFMのコンタクトモードにより、0.01nNの低荷重下でパターン観察を行う。この荷重下では、パターン変形および剥離は生じない。そして、レジストパターン上部の角に30nNの荷重を加えることでパターンを倒壊させる(図1a)。最後に、剥離倒壊したパターンの側面形状をコンタクトモードにより精密に測定する(図1b)。
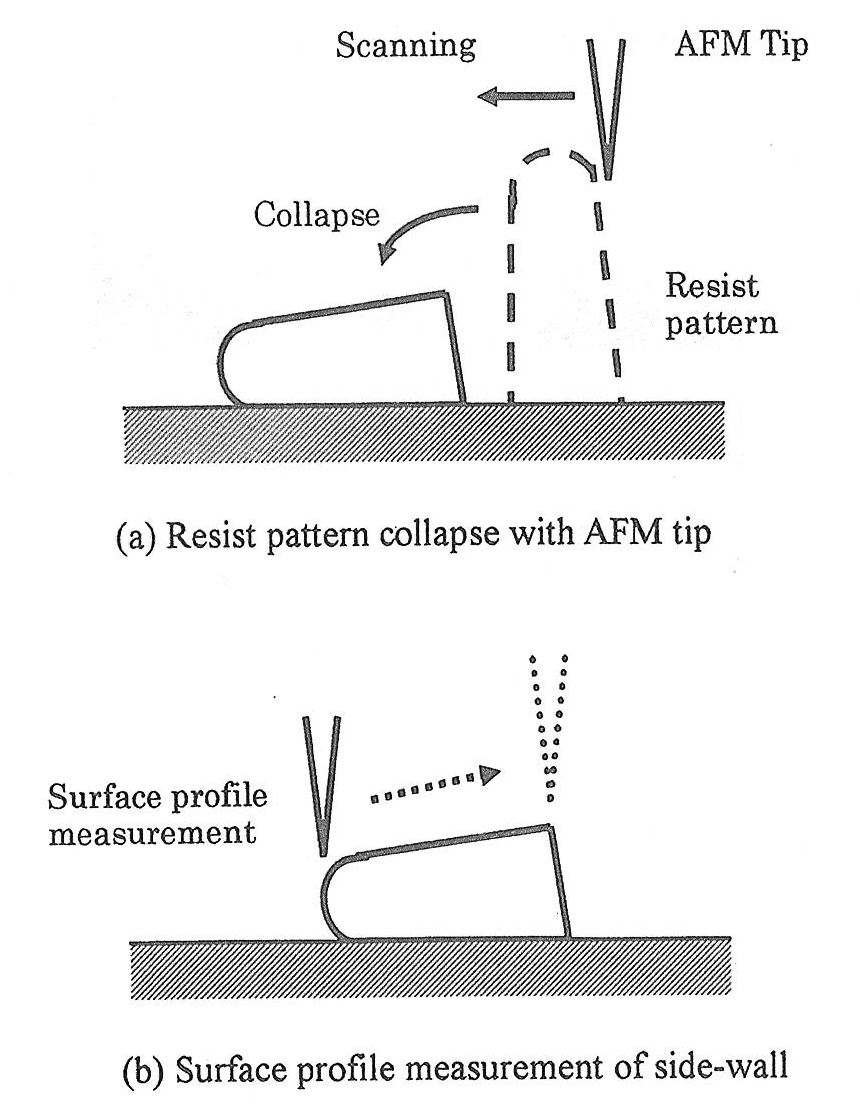
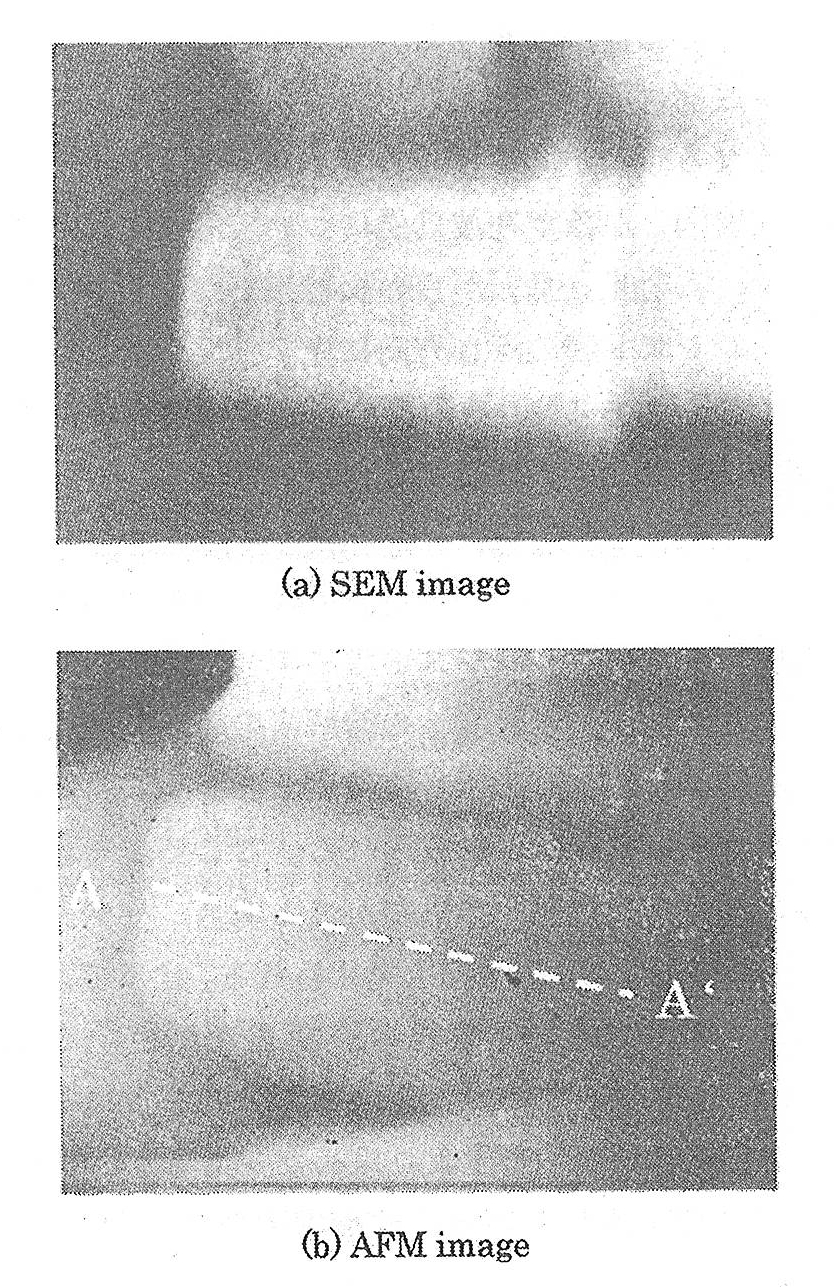
AFM像の中からパターンを1つ選択して、図1で示したように、荷重を加えて剥離倒壊させる。図2には、倒壊後のレジストパターンのSEMおよびAFM像をそれぞれ示している。両者ともパターン側面に波型模様が確認できる。そして、図3aには図2bのAFM像のA-A’面での断面形状プロファイルを示す。波形模様はパターン上部から底部にかけて形成されているが、その周期と深さは僅かに変化していることが分かる。特に、パターン底部に近いほど周期が短くなり、かつ、その凸凹は大きくなる傾向がある。ここで、パターン側面の波型模様の形成要因となる定在波効果について考察する。定在波効果とは、入射光と基板からの反射光とがレジスト膜中で干渉し、レジスト膜の深さ方向に光学強度の濃淡が周期的に生じることである。その場合の光学強度の濃度変化の周期T(nm)は、下式で表すことができる。
T=λ/2n
ここで、λ(nm)は入射光の波長、nは波長λにおけるレジストの屈折率である。レジスト膜の場合、深さ方向の光学強度の濃度変化が、現像液への溶解度の差として反映される。その結果、図2および図3aのような周期的な波形模様がパターン側面に形成される。ここで、もし、レジスト膜の深さ方向に屈折率分布がある場合、パターン側面の波形模様の周期も変化すると考えられる。よって、パターン側面に形成された波形模様の周期Tを測定することによって、レジストパターン内の屈折率分布を求めることができる。図3bは上式より求めたレジストパターン内の屈折率分布を示している。屈折率の値は1.51から1.79の範囲内で変化しており、最小自乗曲線から分かるように。パターン上部より底部の方が高くなっている。これは、図4のように、スピンコート法で形成したレジスト膜において、基板との界面付近の屈折率は、膜表面よりも高いことを示している。また、図3bより、波形模様の深さはパターン底部に近いほど高くなっているため、露光時の定在波効果もパターン底部の方が顕著である。これは、レジスト膜表面よりも、基板近傍の反射光強度が高くなるためである。


ここで、レジストパターンの屈折率変化と凝集性との関係について考察する。一般に、物質の屈折率nは、誘電率εと密接な関係がある。これらは、下式のクラウジウス-モソッテイの式として、単位体積当たりの分子数(分子濃度)Nおよび分極率αの関数として表わされる。

この式において、ΣNα<3ε0の範囲で解が得られるため、屈折率nおよび誘電率εはΣNα項の増加関数となる。すなわち、レジスト膜の屈折率nの増加は、レジスト内の分子濃度Nあるいは分子分極率αの増加に起因することが分かる。また、本研究では、スピンコート後のレジスト膜に100℃の熱処理を行っている。しかし、レジスト樹脂のクロスリンクは通常約200℃以上で顕著になることが分かっている。よって、レジスト膜の分子構造に起因する分極率αは、100℃の熱処理では殆ど変化していないと考えられる。一方、熱処理による溶剤蒸発により、レジストパターン内の残留溶剤の濃度分布が変化したと考えられる。これは、レジスト膜の熱処理にホットプレートを用いたため、レジスト膜が底部から加熱されて溶剤蒸発が生じることが予測される。すなわち、パターン底部は、パターン上部に比べて残留溶剤量が少なく、それに伴い、パターンの体積収縮も大きくなると考えられる。よって、パターン底部では、レジスト内の単位体積当たりの分子数Nが増加すると考えられる。すなわち、図4のように、レジスト膜内には深さ方向に屈折率分布が生じていると考えられる。よって、現像後のパターン内にも同様の屈折率変化が生じていることが分かる。このように、本手法によれば、レジストパターン内の凝集特性が解析できる。また、微小固体中の屈折率分布を決定できることから、フォトニクス材料のような機能素子の光学解析を解析できる。