近年、MEMS(Micro Electro Mechanical Systems, 微小電子機械素子)は、自動車のエアバッグやゲーム機などの主要な部品である加速度センサが相当し、センサ、制御機器、バイオ分野などで目覚しく発展している。MEMSの作製には、有機無機の多くの薄膜が用いられている。また、バルク体を薄膜化するダイヤフラム薄膜も多く用いられている。ここでは、ダイヤフラム薄膜の作製プロセス、および制御技術について述べるとともに、ダイヤフラム型流体制御MEMSの動作原理について紹介する。
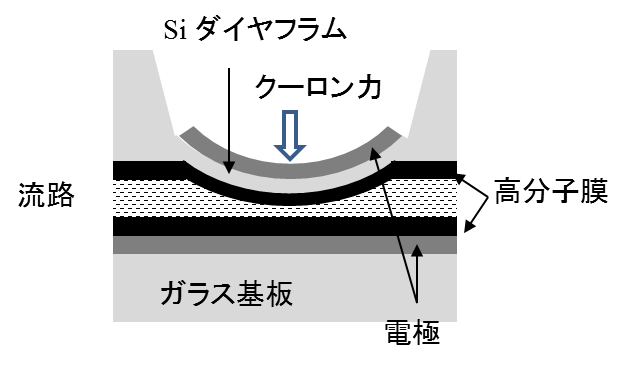
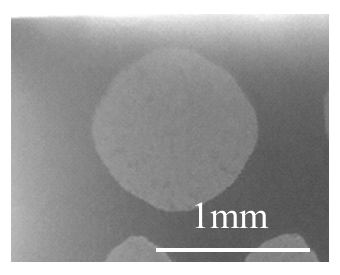
上の左図はマイクロダイヤフラムの断面構造を示している。材質はシリコン(Si)であり、ダイヤフラムの直径は1mm、厚さは30ミクロンである。このダイヤフラムはSi単結晶のウェットエッチングにより形成する。ダイヤフラムの上面にはAu電極膜が形成されている。また、ダイヤフラムの下面には、ポリマー膜がコートされている。ダイヤフラムはマイクロチャネル(流路)に接続されており、流体の流れを制御できる機構を有している。チャネルの幅は50ミクロンである。これらは光リソグラフィ技術で作製する。制御する流体として、液体やガスなどが選択できる。特に、反応性や腐食性のある流体に適用可能である。このダイヤフラムは繰り返し動作させるため、繰り返し疲労耐性が求められる。上の右図は、マイクロダイヤフラムの形成後の顕微鏡写真である。ダイヤフラムの表面は、平坦であることが確認できる。
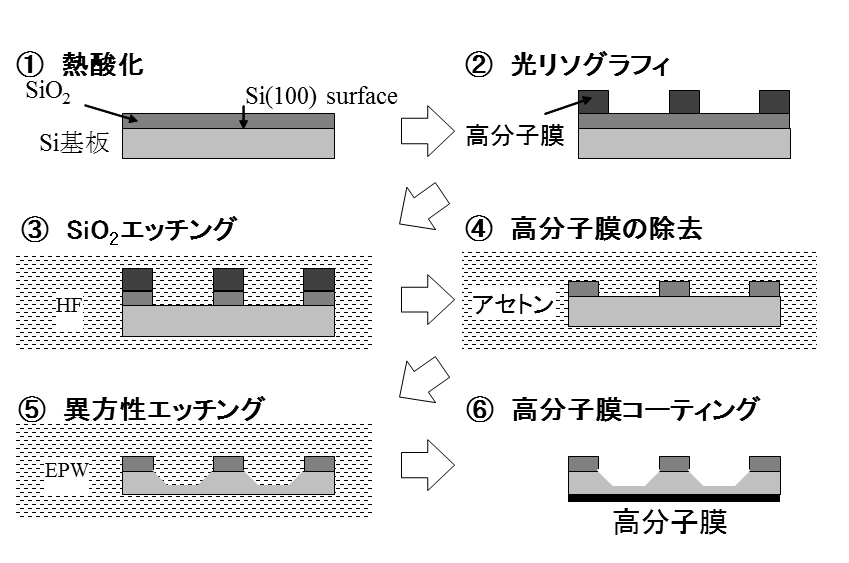
上図は、Si製のマイクロダイヤフラムの形成フローを示している。最初に、Si基板表面にエッチングマスクとなるSiO2膜を形成する。SiO2膜の膜厚は45nm程度であり、電気炉を用いた熱酸化法で形成する。次に、高分子膜によるダイヤフラムの形状パターンを、光リソグラフィ法で形成する。これはSiO2膜のエッチングマスクとなる。そして、HFF水溶液に浸漬することにより、SiO2膜を溶解除去する。その後、アセトンなどの有機溶剤等により、マスク材料であった高分子膜を溶解除去する。Si基板は、SiO2パターンをマスクとして、開口部を所望の深さにまで溶解する。この際、エッチング溶液には通常EPW溶液を用いる。そして、SiO2膜をHF水溶液中で除去する。以上のプロセスで所望の膜厚にダイヤフラム膜を制御できる。最終的に、制御用の金属電極膜や高分子膜をコーティングして、マイクロダイヤフラムが完成する。
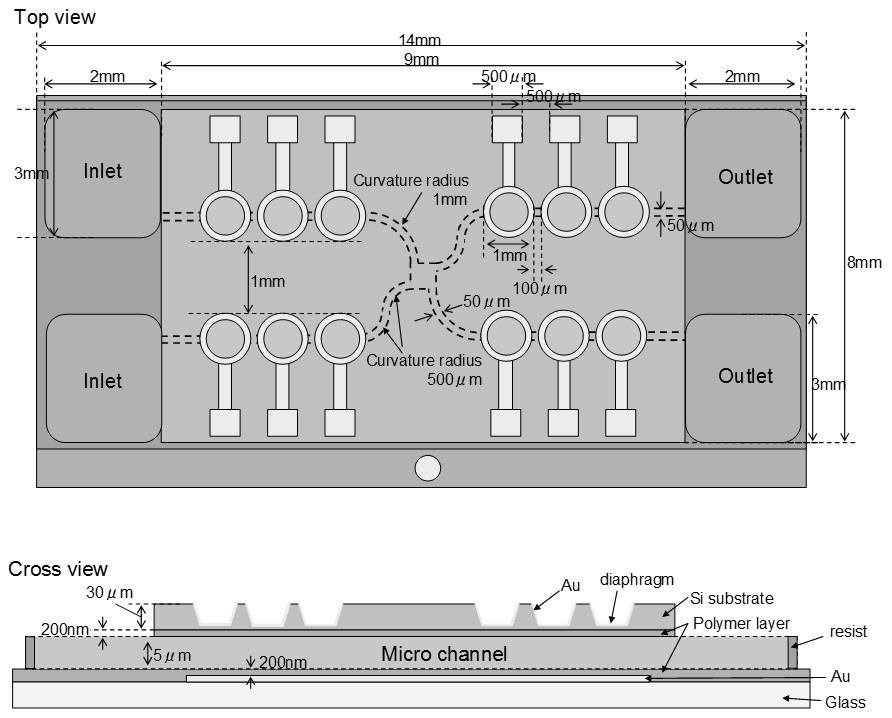
上図は、これらのダイヤフラムを搭載した流体制御MEMSのデザイン図である。中央部に円形の12個のダイヤフラムが確認できる。各ダイヤフラムには、電圧印加用の配線が接続されている。また、デバイスの左端には流体供給口、右端には流出口が設けられている。供給口は2系統あり、流出口も2系統である。各ダイヤフラムはマイクロチャネルで結合されている。3個が一つのブロックを形成し、4ブロックに分けられている。中央部でチャネルは交差しており、流入した2種類の流体を混合・分離制御することが可能である。下図は、1つのブロックを構成する3個のダイヤフラムの動作シーケンスを示している。①:左端のダイヤフラムは圧縮し、流体を押し出す。その際、右端のダイヤフラムは拡張し流体を吸入する。②:中央のダイヤフラムが圧縮し、右側へ流体を押し出す。これらの①、②のシーケンスにより、ダイヤフラム内の流体は左から右へ移動する。③:左端のダイヤフラムが拡がることで、新たな流体を吸入する。④:中央のダイヤフラムが拡張することで、さらに吸入する。以上の①~④のシーケンスにより、流体制御ができる。また、ダイヤフラムの動作周期を変えることで、流体の流量制御が可能となる。MEMS内の左右2ブロックを機能的に動作させることで、2種類の液体の混合および分離制御が可能となる
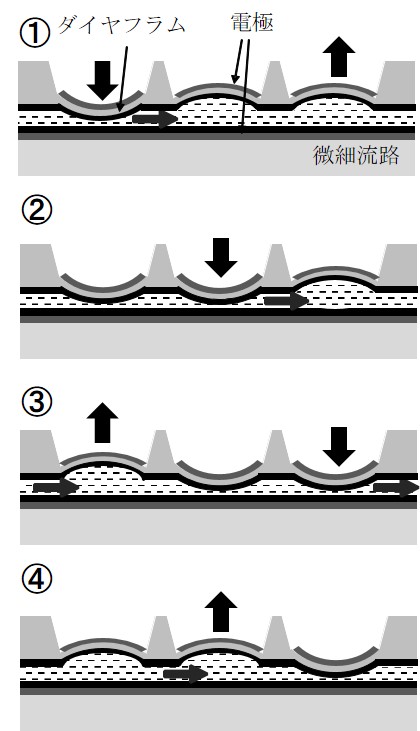
下の左図は、実際に作製し動作させた流体制御MEMSの写真を示している。デバイス形状は平坦的であり、コンパクトなパッケージングが可能である。制御用の配線も多数確認できる。この流体制御MEMSは、流体との接触面に高分子膜を適用しており、反応性および腐食性流体を取り扱うことができる。ここでは、下の右図のようなシランカップリングガスの制御について紹介する。シランカップリング剤としてHMDS(ヘキサメチルジシラザン)を用いる。通常、シランカップリング処理は、バブリングや気化器などでガス化し、N2などのキャリアガスで送流する。
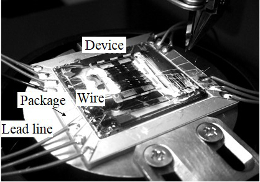
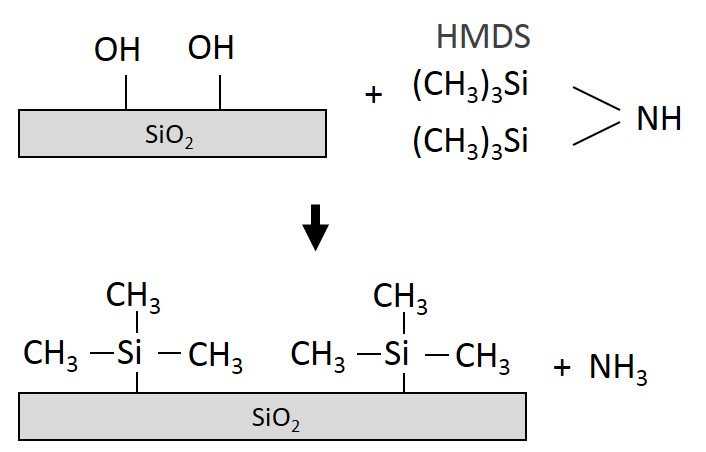
固体表面の濡れ性は、下の左図のように、純水の接触角として敏感にモニターすることが可能である。疎水化処理を行うことで、接触角は増大する。下の右図にはMEMSデバイスの流出口におけるガラス基板について、純水接触角にて評価した結果を示している。接触角が高いほど、疎水化処理が進んでいることを示している。時間の経過とともに、最初15度であった親水性表面が、流体制御MEMSによる処理により55度まで上昇し、疎水性ガスが導入されていることが明確である。このように、MEMSデバイスの中でも、コーティング技術は重要な役割をしている。今後も、単なる保護膜コーティングではなく、デバイスの構成要素の一つとして有効に機能させることができる。
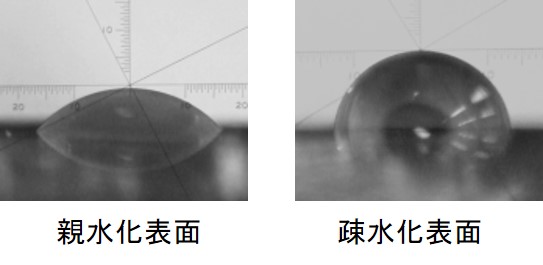

参考文献