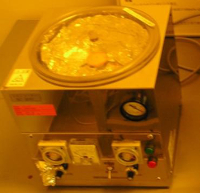
スピンコート法は、その均一性、プロセス、装置の簡易さにより多くの産業で用いられている。液晶や半導体デバイスにおいて、フォト高分子膜のコーティングや現像時のスピン乾燥に用いられている。右図はスピンコート装置の外観写真を示している。膜厚均一性を向上にはスピン乾燥が効果的だが、そのためウェハ周辺部の周速度は速くなり、高分子膜からの溶剤蒸発が不均一となる。高分子材料(レジスト)は、ノボラック樹脂 (m-クレゾール、p-クレゾール)、感光剤 (ナフトキノンジアジド)、溶剤 (エチルセルソルブアセテート) の混合物である。残留溶剤の絶対量は、高分子膜の重量変化として求める。また、スピン乾燥と高分子膜質との関係を調べるため、接触角や屈折率などを用いて解析する。純水の接触角は、高分子膜上に滴下して1分後の値を測定する。下の左図は高分子膜のウェハ半径方向の屈折率分布を示している。スピンコート後の高分子膜では、ウェハエッジに近づくにつれて屈折率がわずかに増加する。これは高分子膜質がウェハ面内で異なることを意味している。また、下の右図は高分子膜中の残留溶剤量を0~11mgの範囲で変化させた時の高分子膜の屈折率変化を示している。高分子膜中の残留溶剤量が減少するにつれて屈折率は増加する。よって下の左図のスピンコート後の高分子膜において、ウェハ周辺部は中央部に比べ溶剤が多く蒸発することが説明できる。これはスピンコート時の周速がウェハ周辺部の方が速く、溶剤の乾燥が促進されるためである。
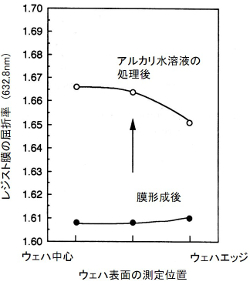
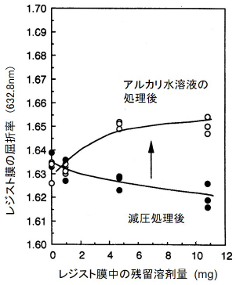
下の左図はスピン乾燥した高分子膜表面において、純水接触角のウェハ半径方向分布を示している。接触角はウェハエッジに近づくにつれ高くなり、また逆にスピンコート回転数の増加に従い低くなる。この結果は上の左図の高分子膜の屈折率分布と同様に、ウェハ面内での高分子膜の残留溶剤量の変化を表している。また、下の右図は、高分子膜内の残留溶剤量と純水接触角との関係を示している。残留溶媒量の減少とともに純水接触角は増加するため、接触角変化は高分子膜の外周部での残留溶媒量の減少を表している。この結果は下の左図の高分子膜内の屈折率分布と一致する。以上のように、高分子膜内の残留溶剤量は、スピン乾燥プロセスに大きく依存する。また、屈折率や接触角測定といった簡単な方法で塗膜の乾燥を解析できることも特長の一つである。


ここでは、代表的な塗膜の乾燥装置について、装置機構および特徴について述べた。試料の大型化だけでなく、高品位な乾燥プロセスの要求が高くなり、乾燥装置の絶え間ない進展がみられる。塗膜の高品質化には、塗膜の性質に適した乾燥装置の選択が重要となる。
参考文献